Лучинин В.В. Физика и технология микро - и наносистем
Подождите немного. Документ загружается.

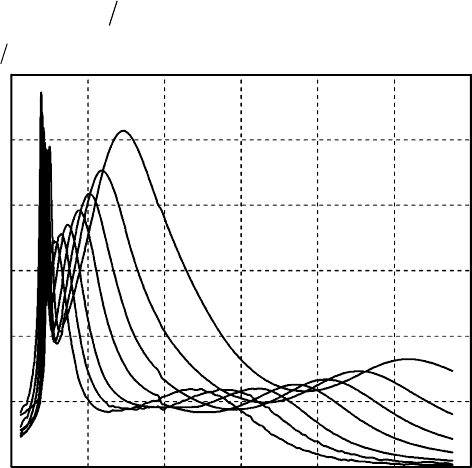
130
вации носителей с уровня квантования в КЯ определяется по темпера-
турной зависимости скорости эмиссии, построенной в координатах
Аррениуса:
(
)
(
)
ln1
n
e fT
= (рис. 4, б).
T, K
50
100
150
200 250
30
25
20
15
10
5
0
1
2
3
4
5
6
7
I
II
III
,
G
w
pF
Рис. 3. Температурный спектр проводимости образца InGaN/GaN
с пятью квантовыми ямами [5]. Цифрами обозначены частоты
тестового сигнала от 5 кГц (1) до 500 кГц (7)
Детальное изучение особенностей графиков Аррениуса и поведе-
ния спектров проводимости в зависимости от величины приложенного
к структуре напряжения может дать важную дополнительную информа-
цию о природе и свойствах глубокой ловушки. Примером служит иссле-
дование гетероструктуры InGaN/GaN с пятью квантовыми ямами с по-
мощью измерений температурных спектров проводимости (рис. 3, 4) [5].
Первый низкотемпературный пик в спектре проводимости (I на
рис. 3), амплитуда которого практически не зависит от приложенного
смещения (рис. 4, а), следует интерпретировать как эмиссию носителей
заряда с мелкого донорного уровня в запрещенной зоне, принадлежа-
щего равномерно распределенной в объеме активной области примеси.
Для таких равномерно распределенных по структуре глубоких центров
не будет наблюдаться зависимости отклика в спектре проводимости от
смещения, в отличие от связанных уровней в квантовой яме, которые
располагаются локально и отклик проводимости от которых будет испы-
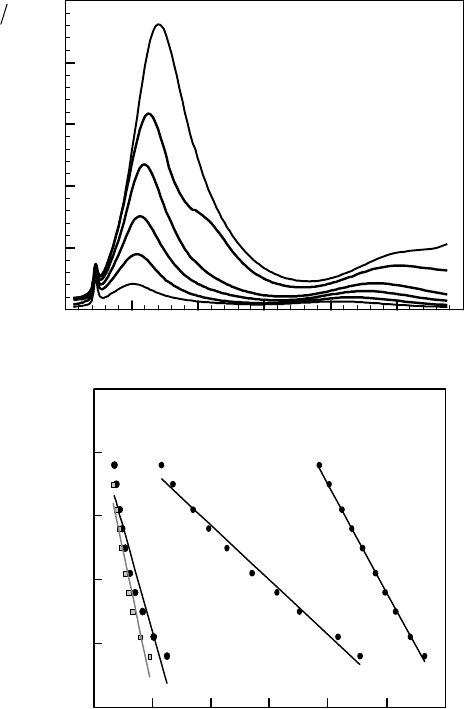
131
50
100
150
200
250
200
150
100
50
0
1
2
3
4
5
6
T, K
,
G
w
pF
а
0
10
20
30
40
10
4
10
5
10
6
10
7
I
II
III
1000/T, K
–1
12
,K
n
es
--
б
Рис. 4. Температурные спектры проводимости (а)
того же образца InGaN/ GaN при частоте сигнала 100 кГц
с различным приложенным прямым смещением
(1 – 0; 2 – 0,8; 3 – 1,6; 4 – 2,0; 5 – 2,3; 6 – 2,5 В)
и графики Аррениуса (б) в координатах
ln(e
n
) = f (1/T). Энергии активации E
a
пиков:
I – 34; II – 17; III – 60…90 мэВ. Приложенное
прямое смещение: кружки – 0 В, квадраты – 2,0 В
тывать сильное влияние приложенного напряжения. Кроме того, от-
сутствие какого-либо уширения исследуемого пика дает основания ут-
верждать, что он не связан с макродефектами типа дислокаций. Энер-
гия активации первого пика, определенная по наклону графика Арре-
ниуса, равна 30 мэВ.
132
В отличие от низкотемпературного пика, амплитуда второго пика
испытывает резкую (на два порядка) зависимость от приложенного
смещения, спадая практически до нуля при U ≤ 0 В. Это объясняется
тем, что при обратном смещении ямы оказываются глубоко внутри об-
ласти объемного заряда, полностью опустошаются и поэтому не участ-
вуют в токопереносе. Кроме того, график Аррениуса данного пика от-
клоняется от линейной зависимости. Совокупность этих особенностей
позволяет связать данный пик с эмиссией носителей заряда непосред-
ственно из квантовой ямы.
Анализ показывает, что энергии активации для первого и второго пи-
ков также не зависят от приложенного смещения. В отличие от этого, рас-
счетная энергия активации третьего пика сильно зависит от приложенного
напряжения, монотонно возрастая с увеличением прямого смещения от 60
до 90 мэВ. График Аррениуса этого пика существенно отклонен от линей-
ной зависимости, что может свидетельствовать о его сильном уширении и,
следовательно, о регистрируемом в данном случае непрерывном распреде-
лении плотности электронных состояний, что обычно связывают с наличи-
ем кластеров в эпитаксиальных слоях нитрида галлия [5].
Особую ценность адмиттансные измерения приобретают для со-
временных высокоэффективных светоизлучающих приборов на кван-
товых ямах. Достигнутый к настоящему времени прогресс в техноло-
гии изготовления таких гетероструктур обеспечивает эффективную
рекомбинацию носителей заряда в основном через квантовую яму, что
неизбежно приводит к обеднению обычно информативных оптических
спектров оптоэлектронных приборов и необходимости поиска новых
методов контроля их характеристик, адекватных современному уров-
ню нанотехнологии.
Важная проблема оптимизации светоизлучающих структур –
контроль соотношения вероятностей излучательной и безызлучатель-
ной рекомбинации. Как показано выше, температурные спектры ад-
миттанса позволяют количественно характеризовать глубокие центры,
являющиеся причиной безызлучательной рекомбинации, и различать
различные эмиссионные источники – уровни квантования, точечные
дефекты и др. [3], [5] (рис. 3, 4).
133
Важную дополнительную информацию об электронном спектре
наногетероструктур можно получить моделированием вольт-фарадных
характеристик и спектров проводимости и последующей «подгонки»
модельных данных к экспериментальным. Развитый на кафедре микро-
и наноэлектроники метод расчета вольт-фарадных характеристик на
основе самосогласованного решения уравнений Пуассона и Шрединге-
ра подробно описан в [3], [4], [6], [7].
Диагностика нанослоев А
3
В
5
и нитридных структур с МКЯ
методами атомно-силовой микроскопии
Современные микро- и нанотехнологии позволяют получать слож-
ные полупроводниковые структуры на основе материалов высокого
кристаллического совершенства с заданными электрофизическими па-
раметрами. Прогресс в технологии синтеза новых материалов, таких
как твердые растворы In
x
Ga
1–x
N, требует дальнейшего развития мето-
дов диагностики, среди которых в последние годы лидирует скани-
рующая зондовая микроскопия. Кроме того, для более глубокой и точ-
ной характеризации свойств наноструктур представляется перспектив-
ным комбинирование электрофизических и зондовых методов, объе-
динение их в единый исследовательско-измерительный комплекс.
Характеризация гомоэпитаксиальных слоев. Атомно-силовая
микроскопия (АСМ) предоставляет уникальные возможности исследо-
вания свойств поверхностей и сколов материалов с разрешением до
атомарного.
Использование АСМ для исследования гомоэпитаксиального арсе-
нида галлия, нитрида галлия на сапфире и гетероструктур InGaN/GaN на
сапфире позволяет выявить механизмы роста слоев и особенности, при-
сущие различным эпитаксиальным технологиям.
Для эпитаксиальных слоев твердых растворов арсенида галлия,
выращенных на подложках из арсенида галлия, всегда наблюдается
планарный рост. Это иллюстрирует рис. 5, на котором представлен
АСМ-скан образца, полученного методом газофазной эпитаксии из ме-
талло-органических соединений (MOCVD).

134
На скане отчетливо видны вин-
товые дислокации со спиральным
ростом, усредненный перепад высот
составляет менее 10 нм. Морфология
поверхности эпитаксиального GaAs,
выращенного на GaAs-подложке, ока-
зывается практически не зависящей
от технологии роста. Это объясняется
идентичностью кристаллической ре-
шетки при гомоэпитаксиальном росте
и, как следствие, незначительным рас-
согласованием постоянных решетки на интерфейсе растущего слоя и
подложки, а также одинаковостью коэффициентов термического рас-
ширения. Эпитаксиальные слои растут планарно.
Таким образом, на поверхности гомоэпитаксиальных слоев при
высоком разрешении измерительной аппаратуры, которого позволяет
достичь АСМ-метод, можно увидеть ступени планарного роста, возни-
кающие вдоль винтовых дислокаций. Опыт изучения различных об-
разцов эпитаксиального GaAs позволяет утверждать, что уровень со-
временной технологии выращивания эпитаксиальных структур на ар-
сениде галлия чрезвычайно высок. Шероховатость эпитаксиальной по-
верхности обычно не превышает нескольких атомных слоев.
Характеризация гетероэпитаксиальных слоев. Технологии вы-
ращивания полупроводников системы AlInGaN еще недостаточно разви-
ты по сравнению с арсенидогаллиевыми технологиями. Одной из важ-
нейших проблем является нестабильность планарного роста. При эпитак-
сии GaN на сапфире морфология растущего слоя сильно зависит от усло-
вий роста, в частности, от вариаций потоков галлия и азота. Измерения
спектров фотолюминесценции и АСМ-сканов показывают, что азото-
обогащенные условия роста GaN позволяют формировать наноколонча-
тую морфологию. Галлий-обогащенные условия приводят к более глад-
кой морфологии, но при этом существенно падает интенсивность ФЛ.
С помощью АСМ нами анализировались выращенные методом
MBE структуры эпитаксиальных слоев GaN на сапфире с различным
Рис. 5. АСМ-скан эпитаксиального
арсенида галлия, выращенного
методом MOCVD

135
соотношением потоков азота и галлия. На рис. 6 представлен АСМ-
скан слоев нитрида галлия, выращенных в галлий-обогащенных
(Ga/N~1,6), а на рис. 7 – в азот-обогащенных (Ga/N~1) условиях.
Рис. 6.
АСМ
-
скан п
оверхност
и
эпитаксиального слоя GaN,
выращенного методом MBE
в галлий-обогащенных условиях
на сапфировой подложке
Рис. 7.
АСМ
-
скан п
оверхност
и
эпитаксиального слоя GaN,
выращенного методом МВЕ
в азот-обогащенных условиях
на сапфировой подложке.
Поперечный размер столбиков
250–300 нм, высота – до 120 нм
По сравнению с гомоэпитаксиальным ростом арсенида галлия
очевиден более развитый рельеф поверхности. Шероховатость в гал-
лий-обогащенных условиях роста составляет более 10 нм, в азот-
обогащенных – 100 нм и более при радиальном размере наноколонок
до 150 нм. АСМ-сканы более гладких образцов, полученных в галлий-
обогащенных условиях, показывают наличие винтовых дислокаций и
развитие роста вокруг них по шестиугольным спиралям. Такая конфи-
гурация определяется вюрцитной структурой нитрида галлия. Из этих
сканов очевидна более высокая неоднородность областей между вин-
товыми дислокациями.
Электрохимическое профилирование
гетероструктур с нанослоями
Измерение распределения концентрации легирующей примеси и
основных носителей заряда по глубине полупроводниковой структуры
является важнейшей операцией контроля полупроводниковых прибо-
ров. Метод измерения вольт-фарадных характеристик давно и успешно
зарекомендовал себя как основной метод данного вида контроля. Од-
136
нако принципиальным ограничением традиционного (электрического)
варианта этого метода является небольшая глубина профилирования,
которая ограничена обратным напряжением пробоя диода Шоттки или
p–n-перехода. Это имеет серьезное значение в случае материалов с вы-
сокими концентрациями носителей заряда, где обедненный слой явля-
ется очень тонким.
Электрохимический C–V-профилометр (ECV-профилометр) по-
зволяет преодолеть это ограничение с помощью системы электрохи-
мического травления. Используя правильно выбранную электрохими-
ческую реакцию растворения, материал можно профилировать до лю-
бой глубины при управляемой и рассчитываемой скорости. Поверх-
ность раздела «полупроводник – электролит» ведет себя как диод
Шоттки и таким образом позволяет выполнять измерения профиля
концентрации носителей заряда.
При использовании электролита как для травления, так и для
формирования контакта Шоттки с полупроводником ECV-профило-
метрия представляет собой оптимальный метод с точки зрения эффек-
тивности измерения концентрации носителей заряда и обеспечения ус-
пеха технологического процесса еще до изготовления прибора.
Метод электрохимического профилирования может эффективно
использоваться для точного послоевого контроля концентрации леги-
рующей примеси, ее распределения по толщине и положения металлур-
гической границы в p–n-переходе. Возможно травление образца на глу-
бину до несколько микрон с точностью травления не хуже 1 нм. Это по-
зволяет применять его для контроля современных наноструктур, толщи-
ны отдельных слоев которых достигают единиц нанометров. Измеренный
с помощью электрохимического профилометра ECV Pro-UV Nanometrics
концентрационный профиль основных носителей заряда в гетерострукту-
ре InGaN/GaN с МКЯ показан на рис. 8, в нем наблюдаются пики от трех
квантовых ям. По этой зависимости можно точно определить период
квантовых ям, а с помощью детального анализа можно получить более
прецизионную и полную информацию о заряде, накопленном в КЯ, и об
особенностях электронного спектра наноструктуры.

137
На рис. 9 представлен профиль концентрации носителей заряда в
p–i–n-структуре на основе GaN. Электрохимический профилометр реа-
гирует на знак заряда, уносимого электролитом, поэтому он позволяет
измерять распределение концентрации электронов и дырок непосредст-
венно в сформированном p–n-переходе готового прибора (рис. 9). Раз-
мытие краев p- и n-областей связано с диффузией носителей заряда в
слаболегированную область на величину нескольких дебаевских длин.
x
, нм
10
20
30
40
50
1
2
3
4
183
,10
см
d
N
-
N414-1 pin GaN
w, мкм
0.0 0.2 0.4 0.6 0.8 1.0 1.2 1.4 1.6
N
A
-N
D
, см
-3
10
17
10
18
10
19
n
p
0
0,4
0,8
1,2
w, мкм
10
17
10
18
10
19
3
,
см
AD
NN
-
-
414-1pin GaN
N
n
p
Рис. 8.
Концентрационный профиль
основных носителей заряда образца
InGaN/GaN с МКЯ, измеренный
с помощью профилометра ECV-Pro-UV
Рис. 9.
Концентрационный профиль
образца p–i–n-GaN
Нужно отметить, что при исследовании полупроводников мето-
дом электрохимического профилирования получаемые значения кон-
центрации, как правило, выше чем значения, измеренные методом
Холла. Различие объясняется тем, что при C–V-измерениях на низких
частотах происходит полная ионизация примеси в приложенном поле
[3], а при холловских измерениях тестируется только ионизованная
часть примеси. Эта доля зависит от энергии ионизации конкретной
примеси и при комнатной температуре может быть в разы меньше ве-
личины легирования.
Электрохимический профилометр позволяет работать в двух ре-
жимах: в режиме вольт-фарадного профилирования с использованием
верхнего жидкостного электролитического контакта и в режиме опре-
деления концентрационного профиля легирующей примеси равномер-
ным стравливанием и измерением количества унесенного заряда по
138
закону Фарадея. Основной проблемой при работе во втором режиме
является точный контроль координаты. Нами предложено совместное
использование метода атомно-силовой микроскопии и метода электро-
химического профилирования, что позволяет устранить потенциальную
погрешность измерений в фарадеевском режиме, связанную с возникно-
вением окислов на поверхности и границах раздела. АСМ-анализом под-
тверждено, что травитель, используемый профилометром ECV-Pro-UV,
является полирующим. Например, шероховатость поверхности эпитакси-
ального GaAs до травления составляет 2-3 нм, а после травления – 8–
10 нм. Таким образом, контролируя глубину и качество травления с по-
мощью атомно-силового микроскопа, можно решить основную проблему
вольт-фарадных измерений – проблему точного определения координаты
в концентрационном профиле носителей заряда.
Виртуальные приборы
Среди всего многообразия средств эксперимента следует особо
выделить активно развиваемые в последнее десятилетие технологии,
использующие «виртуальные приборы». Их рассматривают как самые
современные технологии создания лабораторных измерительных сис-
тем на базе компьютера.
Виртуальным прибором (virtual instrument) называют компьютер
с платами сбора информации и соответствующим программным обес-
печением, выполняющий функции настоящего измерительного прибо-
ра. Составными частями виртуального прибора являются графический
язык программирования LabVIEW, платы сбора информации (встроен-
ные в компьютер и внешние), драйверы устройств [8].
Научно-ориентированная система графического программирова-
ния LabVIEW вместе с соответствующими встраиваемыми в ПК пла-
тами сбора информации может охватывать все этапы научного иссле-
дования – от съема информации с конкретного физического устройства
или датчика до презентации результатов в Интернете, в том числе не-
посредственно в режиме on-line.
Разработанный в нашей лаборатории виртуальный прибор для
измерений вольт-амперных характеристик полупроводников показан
на рис. 10. Его основой является блок NI-USB-6009 – портативное уст-
ройство сбора данных с 8 аналоговыми входами, двумя аналоговыми

139
выходами и 12 цифровыми входами/выходами. Передача данных осу-
ществляется через порт USB 2.0, что позволяет подключать устройство
к любому компьютеру или ноутбуку. Программирование выполнено в
графической среде LabVIEW.
Рис. 10. Малогабаритный виртуальный прибор для измерений ВАХ,
выполненный с использованием NI-USB-6009 [8]
Использование плат сбора данных, подобных блоку NI-USB-6009,
дает возможность строить компактные виртуальные приборы для раз-
личных экспресс-измерений, позволяющие измерять токи и напряже-
ния в приемлемом для современной электроники диапазоне. Реализуе-
мая подобным образом технология виртуальных приборов символизи-
рует переход от обычных приборов к измерительным системам на базе
компьютера с соответствующим программным обеспечением.
Заключение
В статье изложены последние результаты по емкостной и адмит-
тансной спектроскопии наногетероструктур. Показано, что разработан-
ная система комплексной диагностики электрофизических параметров
полупроводниковых гетероструктур с одиночными и множественными
квантовыми ямами на основе спектроскопии адмиттанса и численного
моделирования с учетом квантово-механических эффектов дает уни-
кальную количественную информацию о параметрах электронного спект-
ра наноструктур.
