Davim J.P. Tribology for Engineers: A Practical Guide
Подождите немного. Документ загружается.


1
2
3
4
5
6
7
8
9
10
10
1
2
3
4
5
6
7
8
9
20
20
1
2
3
4
5
6
7
8
9
30
30
1
2
3
34R
34R
18
Tribology for Engineers
1.5 Multiscale characterization of
surface topography
The deviation of a surface from its mean plane is assumed to
be a random process, which is characterized by the statistical
parameters such as the variance of the height, the slope and
the curvature. But, it has been observed that surface topography
is a non-stationary random process. It means the variance of
the height distribution is related to the sampling length and
hence is not unique for a particular surface. Rough surfaces
are also known to exhibit the feature of geometric self-
similarity and self-affi nity, by which similar appearances of
the surface are seen under the various degrees of magnifi cation
as quantitatively shown in Fig. 1.11. Since increasing amounts
of detail in the roughness are observed at decreasing length
scale, the concepts of slope and curvature, which inherently
assume the smoothness of the surface, cannot be defi ned.
So the variances of slope and curvature depend strongly on
the resolution of the roughness-measuring instrument or some
other form of fi lter and are therefore not unique (Ling, 1990;
Majumdar and Bhushan, 1990; Ganti and Bhushan, 1995;
Sahoo and Roy Chowdhury, 1996). In contemporary literature
such a large number of characterization parameters occur that
the term ‘parameter rash’ is aptly used. The use of instrument-
dependent parameters shows different values for the same
Qualitative description of statistical self-affi nity
for a surface profi le
Figure 1.11

1
2
3
4
5
6
7
8
9
10
10
1
2
3
4
5
6
7
8
9
20
20
1
2
3
4
5
6
7
8
9
30
30
1
2
3
34R
34R
19
Surface topography
surface. Thus, it is necessary to characterize rough surfaces
by intrinsic parameters, which are independent of all scales
of roughness. Since this ‘one-scale’ characterization provided
by statistical functions and parameters is insuffi cient to
describe the multiscale nature of tribological surfaces, new
‘multiscale’ characterization methods need to be developed.
Recent developments in this area have been concentrated
mostly on four different approaches: Fourier transform
methods; wavelet transformation methods; fractal methods;
and the hybrid fractal-wavelet method.
Fourier transform methods basically decompose the
surface data into complex exponential functions of different
frequencies. The Fourier methods are used to calculate the
power spectrum and the autocorrelation function in order to
obtain the surface topography parameters. However, the
diffi culty with the application of these methods is that they
provide results which strongly depend on the scale at which
they are calculated, and hence they are not unique for a
particular surface. This is because the Fourier transformation
provides only the information whether a certain frequency
component exists or not. As the result, the surface parameters
calculated fail to provide information about the scale at
which the particular frequency component appears.
Wavelet methods decompose the surface data into different
frequency components and characterize it at each individual
scale. While applying wavelets, the surfaces are fi rst
decomposed into roughness, waviness and form. Then the
changes in surface peaks, pits and scratches, together with
their locations, are obtained at different scales. However,
there are still major problems in extracting the appropriate
surface texture parameters from wavelets.
The fractal method incorporates fractal dimension which is
an intrinsic property of multiscale roughness of surface
characterization. It is invariant with length scales and is closely

1
2
3
4
5
6
7
8
9
10
10
1
2
3
4
5
6
7
8
9
20
20
1
2
3
4
5
6
7
8
9
30
30
1
2
3
34R
34R
20
Tribology for Engineers
linked to the concept of geometric self-similarity. The self-
similarity or self-affi nity of rough surfaces implies that as the
unit of measurement is continuously decreased, the surface
area of the rough surface (a two-dimensional measure) tends to
infi nity and the volume (a three-dimensional measure) tends
to zero. Here, self-similarity implies the property of equal
magnifi cation in all directions while self-affi nity refers to
unequal scaling in different directions. Thus, the Hausdorff or
fractal dimension, D + 1, of rough surfaces is a fraction between
2 and 3. The profi le of a rough surface Z(x), typically obtained
from stylus measurements, is assumed to be continuous even at
the smallest scales. This assumption breaks down at atomic
scale. But for engineering surfaces the continuum is assumed to
exist down to the limit of a zero-length scale. Since repeated
magnifi cations reveal the fi ner levels of detail, the tangent at
any point cannot be defi ned. Thus the surface profi le is
continuous everywhere but non-differentiable at all points.
This mathematical property of continuity, non-differentiability
and self-affi nity is satisfi ed by the Weierstrass-Mandelbrot
(W-M) fractal function, which is thus used to characterize and
simulate such profi les. The W-M function has a fractal
dimension D, between 1 and 2, and is given by
Z(x)
L(G / L)
D1
兺
∞
cos 2
πγ
n
(x / L)
, 1
<
D
<
2,
γ
>
1 [1.15]
nn
1
γ
(2D)n
where G is a scaling constant. The parameter n
1
corresponds
to the low cut-off frequency of the profi le. Since surfaces are
non-stationary random process the lowest cut-off frequency
depends on the length L of the sample and is given by
γ
n1
= 1/L. The W-M function has the interesting mathematical
property that the series for Z(x) converges but that for dZ/dx
diverges. It implies that it is non-differentiable at all points.
The power spectrum of this W-M function can be expressed
by a continuous function as

1
2
3
4
5
6
7
8
9
10
10
1
2
3
4
5
6
7
8
9
20
20
1
2
3
4
5
6
7
8
9
30
30
1
2
3
34R
34R
21
Surface topography
P(
ω
)
G
2(D1)
1 [1.16]
2ln
γ
1
ω
52D
When this equation is compared with the power spectrum of
a surface, the dimension D is related to the slope of the
spectrum on a log-log plot against
ω
. The constant G is
the roughness parameter of a surface, which is invariant
with respect to all frequencies of roughness and determines
the position of a spectrum along the power axis. In this
characterization method both G and D are independent of
the roughness scales of the surface and hence intrinsic
properties. The constants of the W-M function, G, D, and
n
1
, form a complete and fundamental set of scale-independent
parameters to characterize a rough surface.
The drawback of fractals is that they characterize surfaces
at all scales while the wavelets provide a description at any
particular scale. A possible solution to these problems is to
use a combination of fractals and wavelets. Recently, a hybrid
fractal-wavelet technique, based on the combination of fractal
and wavelet methods, has been developed allowing for the
3-D characterization of often complex tribological surfaces
with a unique precision and accuracy, without the need for
any parameters. First, the surface topography features are
broken down into individual scale components by wavelets
and then fractals are applied to provide a surface topography
description over the fi nest achievable range of scales.
1.6 Surface roughness measurement
The surfaces of any engineering component contain a vast
number of peaks and valleys and it is not possible to measure
the height and location of each of the peaks. So measurements
are taken from a small and representative sample of the surface

1
2
3
4
5
6
7
8
9
10
10
1
2
3
4
5
6
7
8
9
20
20
1
2
3
4
5
6
7
8
9
30
30
1
2
3
34R
34R
22
Tribology for Engineers
so chosen that there is a high probability for the surface lying
outside the sample to be statistically similar to that lying
within the sample. Over the years many different methods
have been devised to study the topography of surfaces and a
brief outline of some of them is presented here.
1.6.1 Surface profi lometer
The most common method of studying surface texture
features is the stylus profi lometer, the essential features of
which are illustrated in Fig. 1.12. A fi ne, very lightly loaded
stylus is dragged smoothly at a constant speed across the
surface under examination. The transducer produces an
electrical signal, proportional to displacement of the stylus,
which is amplifi ed and fed to a chart recorder that provides a
magnifi ed view of the original profi le. But this graphical
representation differs from the actual surface profi le because
of difference in magnifi cations employed in vertical and
Component parts of a typical stylus surface-
measuring instrument
Figure 1.12

1
2
3
4
5
6
7
8
9
10
10
1
2
3
4
5
6
7
8
9
20
20
1
2
3
4
5
6
7
8
9
30
30
1
2
3
34R
34R
23
Surface topography
horizontal directions. Surface slopes appear very steep on
a profi lometric record though they are rarely steeper than
10° in actual cases. The shape of the stylus also plays a vital
role in incorporating error in measurement. The fi nite tip
radius (typically 1 to 2.5 microns for a diamond stylus) and
the included angle (of about 60° for pyramidal or conical
shape) results in preventing the stylus from penetrating fully
into deep and narrow valleys of the surface and thus some
smoothing of the profi le is done. Some error is also introduced
by the stylus in terms of distortion or damage of a very
delicate surface because of the load applied on it. In such
cases a non-contacting optical profi lometer having optical
heads replacing the stylus may be used. Refl ection of infrared
radiation from the surface is recorded by arrays of photodiodes
and analysis of these in a microprocessor results in the
determination of the surface topography. Vertical resolution
of the order of 0.1 nm is achievable though maximum height
of measurement is limited to a few microns. This method is
clearly advantageous in cases of very fi ne surface features.
1.6.2 Optical microscopy
In this method, the surface of interest is held to refl ect a beam
of visible light and then these are collected by the objective of
the optical microscope. An image of the surface is produced
and is analysed at very high rates of resolution (up to
0.01 microns) by optical interferometers. Depth of fi eld
achievable is up to 5 microns. But success of the method depends
on the refl ective property of the material, which limits its use.
Optical methods may be divided into two groups: geometrical
methods and physical methods. Geometrical methods include
light-sectioning and taper-sectioning methods, while physical
methods include specular refl ection, diffuse refl ection, speckle
pattern and optical interference.

1
2
3
4
5
6
7
8
9
10
10
1
2
3
4
5
6
7
8
9
20
20
1
2
3
4
5
6
7
8
9
30
30
1
2
3
34R
34R
24
Tribology for Engineers
In the light-sectioning method, the image of a slit is thrown
onto the surface at an incident angle of 45°. The refl ected
image appears as a straight line if the surface is smooth and as
an undulating line if the surface is rough. In the taper-sectioning
method, a section is cut through the surface to be examined at
an angle of θ, thus effectively magnifying the height variation
by a factor of cot θ, and is subsequently examined by an
optical microscope. The surface is supported with an adherent
coating that prevents smearing of the contour during the
sectioning process, while the taper section is lapped, polished
and lightly heat tinted to provide good contrast for optical
examination. This process suffers from disadvantages like
destruction of test surface and tedious specimen preparation.
In the specular refl ection method, gloss or specular
refl ectance that is a surface property of the material and a
function of refl ective index and surface roughness, is measured
by gloss meter. Surface roughness scatters the refl ected light
and affects the specular refl ectance, thus a change in specular
refl ectance provides a measure for surface roughness.
The diffuse refl ection method is particularly suitable for
on-line roughness measurement during manufacture since it
is continuous, fast, non-contacting and non-destructive. This
method employs three varieties of approaches. In the total
integrated scatter (TIS) approach, the total intensity of the
diffusely scattered light is measured and used to generate the
maps of asperities, defects and particles rather than micro-
roughness distribution. The diffuseness of the scattered light
(DSL) approach measures a parameter that characterizes
the diffuseness of the scattered radiation pattern and relates
this to surface roughness. In the angular distribution (AD)
approach, the scattered light provides roughness height,
average wavelength or average slope. With rougher surfaces,
this may be useful as a comparator for monitoring both
amplitude and wavelength surface properties.

1
2
3
4
5
6
7
8
9
10
10
1
2
3
4
5
6
7
8
9
20
20
1
2
3
4
5
6
7
8
9
30
30
1
2
3
34R
34R
25
Surface topography
In the speckle pattern method, surface roughness is related
to speckle, which is basically the local intensity variation
between neighbouring points in the refl ected beam when a
surface is illuminated with partially coherent light.
The optical interference technique involves looking at the
interference fringes and characterizing the surface with
suitable computer analysis. Common interferometers include
the Nomarski polarization interferometer and Tolanski
multiple beam interferometer.
1.7 Advanced techniques for surface
topography evaluation
A further improvement in the resolution of surface
topographic examination is possible by the use of electron
microscopes. Two basic types of electron microscopes are
available: scanning electron microscopes and transmission
electron microscopes. In scanning electron microscopy
(SEM) a focused beam of high-energy electrons is incident
on the surface at a point resulting in the emission of secondary
electrons. These are then collected and fed to an amplifi er to
send an electric signal to a cathode ray tube (CRT). The
electron beam is scanned over the surface to have a complete
picture and the CRT screen gives a topographical image of
the entire area of interest. Depth of fi eld is up to 1,000 microns,
which acts as a primary advantage of this method over the
optical method, but one drawback is the requirement on size
of the specimen to be placed within the vacuum chamber of
the instrument. This can be overcome by preparing a replica
of the surface.
In transmission electron microscopy (TEM), the focused
beam of high-energy electrons is made to transmit through a
very thin specimen and the defl ection and scattering of the

1
2
3
4
5
6
7
8
9
10
10
1
2
3
4
5
6
7
8
9
20
20
1
2
3
4
5
6
7
8
9
30
30
1
2
3
34R
34R
26
Tribology for Engineers
electrons is recorded to analyse surface topography. Preparation
of a specimen thin enough to transmit electrons plays a vital
role and sometimes a replica of the surface retaining all the
texture features but of a material having greater electron
transparency is produced for the same purpose.
Recently, a different type of electron microscopy called
scanning tunnelling electron microscopy (STM) has been
introduced. It incorporates the electron-tunnelling phenomenon
through an insulating layer separating two conductors. The
sharp pointed tip of a probe forms one electrode and the
surface of the specimen the other. The probe is moved by a
highly precise positional controller to keep the tunnelling
current at a steady value and provides an image of the surface
under examination. The method is superior to the earlier ones
in that it does not require any vacuum, but the one disadvantage
is the poor design of the controller mechanism. The principle
of the STM is very simple. Just like in a record player, the
instrument uses a sharp needle, referred to as the tip, to
investigate the shape of the surface, but the STM tip does not
touch the surface. The schematic of the method is shown in
Fig. 1.13. A voltage is applied between the metallic tip and the
specimen, typically ranging between a few milli-volts and
several volts. The tip touching the surface of the specimen
results in a current and when the tip is far away from the
surface, the current is zero. The STM operates in the regime of
extremely small distances between the tip and the surface of
only 0.5 to 1.0 nm, which are typically 2 to 4 atomic diameters.
At these distances, the electrons can jump from the tip to the
surface or vice versa. This jumping is necessarily a quantum
mechanical process, known as ‘tunnelling’ and hence the name
‘scanning tunnelling microscope’. The STMs usually operate
at tunnelling currents between a few pico-Amperes (pA) and a
few nano-Amperes (nA). The tunnelling current depends
critically on the precise distance between the last atom of the
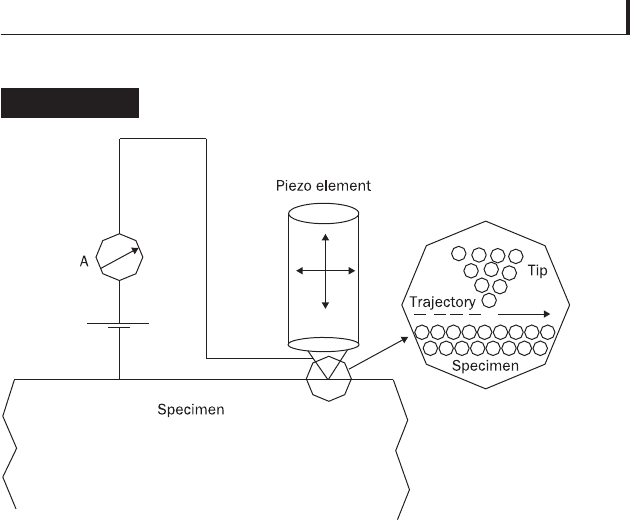
1
2
3
4
5
6
7
8
9
10
10
1
2
3
4
5
6
7
8
9
20
20
1
2
3
4
5
6
7
8
9
30
30
1
2
3
34R
34R
27
Surface topography
tip and the nearest atom or atoms of the underlying specimen.
When this distance is increased a little bit, the tunnelling
current decreases heavily. As a thumb rule, for each extra atom
diameter that is added to the distance, the current becomes a
factor of 1,000 lower. Thus the tunnelling current provides a
highly sensitive measure of the distance between the tip and the
surface. The STM tip is attached to a piezo-electric element,
which changes its length a little bit when it is put under an
electrical voltage. The distance between the tip and the surface
can be regulated by adjusting the voltage on the piezo element.
In most STMs, the voltage on the piezo elements is adjusted in
a manner that the tunnelling current always has the same value,
say 1 nA. Thus the distance between the last atom on the tip
and the nearest atoms on the surface is kept constant. Using so
called electronics, the distance regulation is done automatically.
The feedback electronics continually measure the deviation of
the tunnelling current from the desired value and accordingly
adjust the position of the tip. While this feedback system is
Schematic of working of STM
Figure 1.13
