Лебедев А.И. Физика полупроводниковых приборов
Подождите немного. Документ загружается.


242
Гл. 4. Полевые транзисторы
металл полупро-
"I ВОДНИК £
/
а
Е
с
№"
F
E
v
qVi
Рис. 4.2. Энергетическая диаграмма идеальной МОП-структуры в режиме
плоских зон (а), обеднения (б) и инверсии (в)
происходит обеднение приповерхностного слоя. Проводимость
полупроводника при этом уменьшается. Если продолжать уве-
личивать напряжение на металлическом электроде, то начиная
с некоторого его значения концентрация электронов вблизи по-
верхности становится выше концентрации дырок и возникает
инверсионный слой n-типа проводимости (рис. 4.2в). Этот ре-
жим называется режимом инверсии. При этом проводимость
полупроводника вновь начинает возрастать с увеличением напря-
жения на электроде. Наконец, в случае, когда на электрод подан
более низкий (отрицательный) потенциал по сравнению с
создаваемое электродом электрическое поле притягивает дырки
и вблизи поверхности полупроводника образуется обогащенный
слой р-типа; этот режим называется режимом обогащения.
При этом проводимость полупроводника также возрастает.
В режиме инверсии принято различать слабую и сильную ин-
версии. Граница между ними отвечает случаю, когда концентра-
ция электронов в инверсионном слое вблизи поверхности равна
концентрации дырок в объеме полупроводника. Как мы увидим
ниже, различие между этими режимами по сути определяется
тем, какие заряды — подвижные или связанные — дают основной
вклад в экранирование электрического поля.
Рассчитаем распределение электрического поля в МОП-
конденсаторе. Для определенности будем рассматривать структу-
ру, созданную на поверхности невырожденного полупроводника
р-типа. Потенциал V(x) в точке х определим как сдвиг поло-
жения краев зон вниз по отношению к их положению в объеме
полупроводника (см. рис.4.26). Если напряженность электри-
ческого поля вблизи поверхности невелика и полупроводник

4.1. Полевые транзисторы с изолированным затвором 243
остается невырожденным, то локальные значения концентраций
электронов и дырок будут определяться выражениями
, ч fqv{x)\ (
q
v(x)
п{х) = Про ехр
кТ
, р{х) =
РрО
ехр ^
кТ
(4.1)
где рро и Про
—
равновесные концентрации дырок и электронов
в объеме полупроводника. Последние концентрации связаны с
концентрацией акцепторной примеси N
a
условием электроней-
тральности:
Рро
~~
п
р0 — Na-
Для нахождения распределения потенциала надо решить од-
номерное уравнение Пуассона:
<fV d£ А-пр
4тг q
[р(х) - п(ж) - АУ •
(4.2)
dx
2
dx е
К сожалению, система уравнений (4.2) и (4.1) не допускает
аналитического решения, однако можно связать напряженность
электрического поля £ в точке х с величиной потенциала V{x) в
той же точке. Поскольку
d£ __
dx dV dx
dEdV _ dS
— С
уравнение (4.2) с учетом (4.1) легко преобразуется к виду
„dS 4тга, ,
4irq
(4.4)
Интегрируя это уравнение по V, находим:
у
8тгд
dV' =
о
8тг кТ
P
P
o(e-
qV/kT
+
+qV/kT - 1) + п
ф
(е*
у
1
кТ
- qV/kT - 1)] . (4.5)
Это уравнение связывает напряженность электрического поля
в каждой точке полупроводника с потенциалом в этой точ-
ке и позволяет, в частности, связать напряженность элек-
трического поля на поверхности полупроводника £„ = £(0)
с поверхностным потенциалом V„ = V(0).

244
Гл. 4. Полевые транзисторы
Найдем теперь величину напряжения на металлическом элек-
троде, создающего заданный поверхностный потенциал в полу-
проводнике. Из условия непрерывности электрической индук-
ции на границе раздела полупроводник-диэлектрик (D
n
= 2>
д
)
следует, что напряженность электрического поля в диэлектрике
равна £
д
= eS
n
/e
д
. Это позволяет, зная толщину диэлектрика d
A>
рассчитать искомое напряжение:
Л
V
3
= V
n3
4- V
n
S
a
d
A
ее У
пз
+ V„ + , (4.6)
д
где С
д
— £д/47Г(^д — удельная емкость слоя диэлектрика, У
П
з
—
потенциал плоских зон, а £
п
— напряженность электрического
поля на поверхности полупроводника, которая связана с V
n
урав-
нением (4.5).
Наведенную электрическим полем поверхностную плотность
заряда на металлическом электроде Q
3
и противоположную ей
по знаку поверхностную плотность заряда в полупроводнике Q
n
„
можно рассчитать с помощью теоремы Остроградского-Гаусса:
<Ээ = -(Эп
П
= ^£|.. (4.7)
Зависимость |Qnn|
от
поверхностного потенциала V„ показана
на рис. 4.3. Величина Q„„ складывается из поверхностной плот-
ности находящегося в обедненном слое заряда ионизованных
примесей Фобедн и поверхностной плотности подвижного заряда
свободных носителей qn
ss
:
Qnn
=
Фобедн 4
n
ss •
В режимах обеднения и слабой инверсии, когда концентрации
электронов и дырок в приповерхностном слое малы по срав-
нению с концентрацией акцепторов, электрическое поле, со-
здаваемое зарядом на металлическом электроде, экранируется
неподвижным зарядом ионизованных акцепторов. При этом про-
странственное распределение электрического поля и потенциала
в области изгиба зон оказывается точно таким же, как и в
барьере Шоттки (см. формулу (1.101) с заменой ND на N
A
),
а индуцированный заряд Q
nn
изменяется пропорционально тол-
щине обедненного СЛОЯ ^обедн (IQnnl ~ |Фобедн| = Ч^а^абеди ~
~ v/Kt
>
см
- Р
ис
- 4-3). В режиме сильной инверсии концентрация
электронов вблизи поверхности становится выше N
A
и теперь
уже основной вклад в экранирование дают свободные электроны.
Из формул (4.5) и (4.7) следует, что в режиме сильной инвер-
сии Ю
пп
| « |gn
ss
| ~ exp{qV
a
/2kT). Такая же экспоненциальная
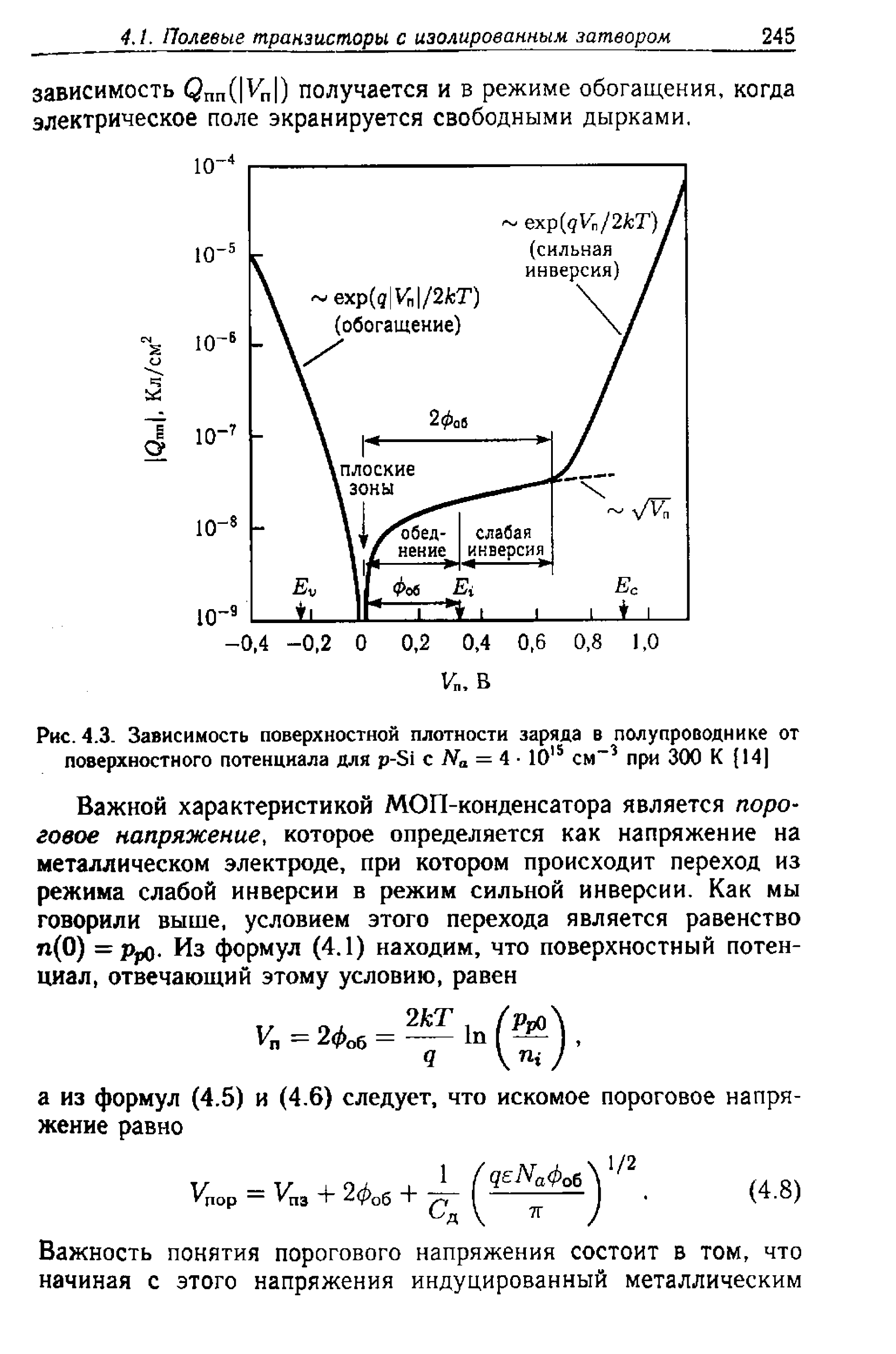
4.1. Полевые транзисторы с изолированным затвором
245
зависимость Q
n
n(|Ki|) получается и в режиме обогащения, когда
электрическое поле экранируется свободными дырками.
сч
2
О
=5
<У
10"
10
-5
10
'б
10
-7
10
-8
10
—9
—0,4 -0,2 0 0,2 0,4 0,6 0,8 1,0
Vn. В
Рис. 4.3. Зависимость поверхностной плотности заряда в полупроводнике от
поверхностного потенциала для р-Si с N
a
= 4 • 10
,s
см"
3
при 300 К (14)
Важной характеристикой МОП-конденсатора является поро-
говое напряжение, которое определяется как напряжение на
металлическом электроде, при котором происходит переход из
режима слабой инверсии в режим сильной инверсии. Как мы
говорили выше, условием этого перехода является равенство
п(0) =р
р
о. Из формул (4.1) находим, что поверхностный потен-
циал, отвечающий этому условию, равен
q \щ
а из формул (4.5) и (4.6) следует, что искомое пороговое напря-
жение равно
1/2
Vnop = v„, +
2фоб
+
1
С
д
деМдфоь
\
7Г )
(4.8)
Важность понятия порогового напряжения состоит в том, что
начиная с этого напряжения индуцированный металлическим

246
Гл. 4. Полевые транзисторы
электродом заряд в полупроводнике начинает определяться по-
движными носителями и, следовательно, в приповерхностном
слое полупроводника появляется проводящий канал. Характер-
ная толщина этого канала составляет 100 А.
Вольт-фарадные характеристики МОП-конденсатора.
Исследование вольт-фарадных характеристик является наи-
более простым методом определения параметров МОП-структур
(толщины диэлектрика, плотности встроенного заряда в нем,
концентрации примеси в полупроводнике и т. д.). Из фор-
мул (4.6) и (4.7) следует, что удельную емкость МОП-
конденсатора dQ
3
/dV
3
можно представить в виде последователь-
но соединенных удельной емкости полупроводника,
Как мы показали выше, индуцированный заряд состоит из
двух составляющих (заряда ионизованных примесей в обеднен-
ном слое и наведенного заряда подвижных носителей), поэтому
и емкость полупроводника С
пп
включает в себя два слагае-
мых: емкость обедненного слоя Собедн =
—
•и емкость
С
навед
= —d(qn
ss
)/dV
n
, связанную с подвижными носителями.
В режимах обеднения и слабой инверсии основной вклад
в dQ
nTl
дает заряд в обедненном слое и, следовательно, на со-
ответствующих участках вольт-фарадной характеристики С
пп
~
^ Собедн- В режимах обогащения и сильной инверсии в dQ
nn
преобладает вклад подвижных носителей, и на этих участках
еМКОСТЬ ПОЛуПрОВОДНИКа Определяется уже ИМИ (С
пп
W С
на
вед).
Удельную емкость обедненного слоя можно легко рассчитать,
зная его толщину. Так, в практически важном случае начала
сильной инверсии (V
n
= 2ф
0
ъ)
Эквивалентная схема МОП-конденсатора показана на
рис. 4.4. Поскольку в режиме инверсии изменение концентрации
наведенных подвижных зарядов вблизи границы полупроводник-
диэлектрик при изменении напряжения на металлическом
электроде происходит за счет тепловой генерации неосновных
носителей в объеме полупроводника (то есть медленно),
Спп = dQ
3
/dV
n
= -dQ
nit
/dV
f
и удельной емкости диэлектрика
Сд = eJ(4*d
A
).
(4.9)
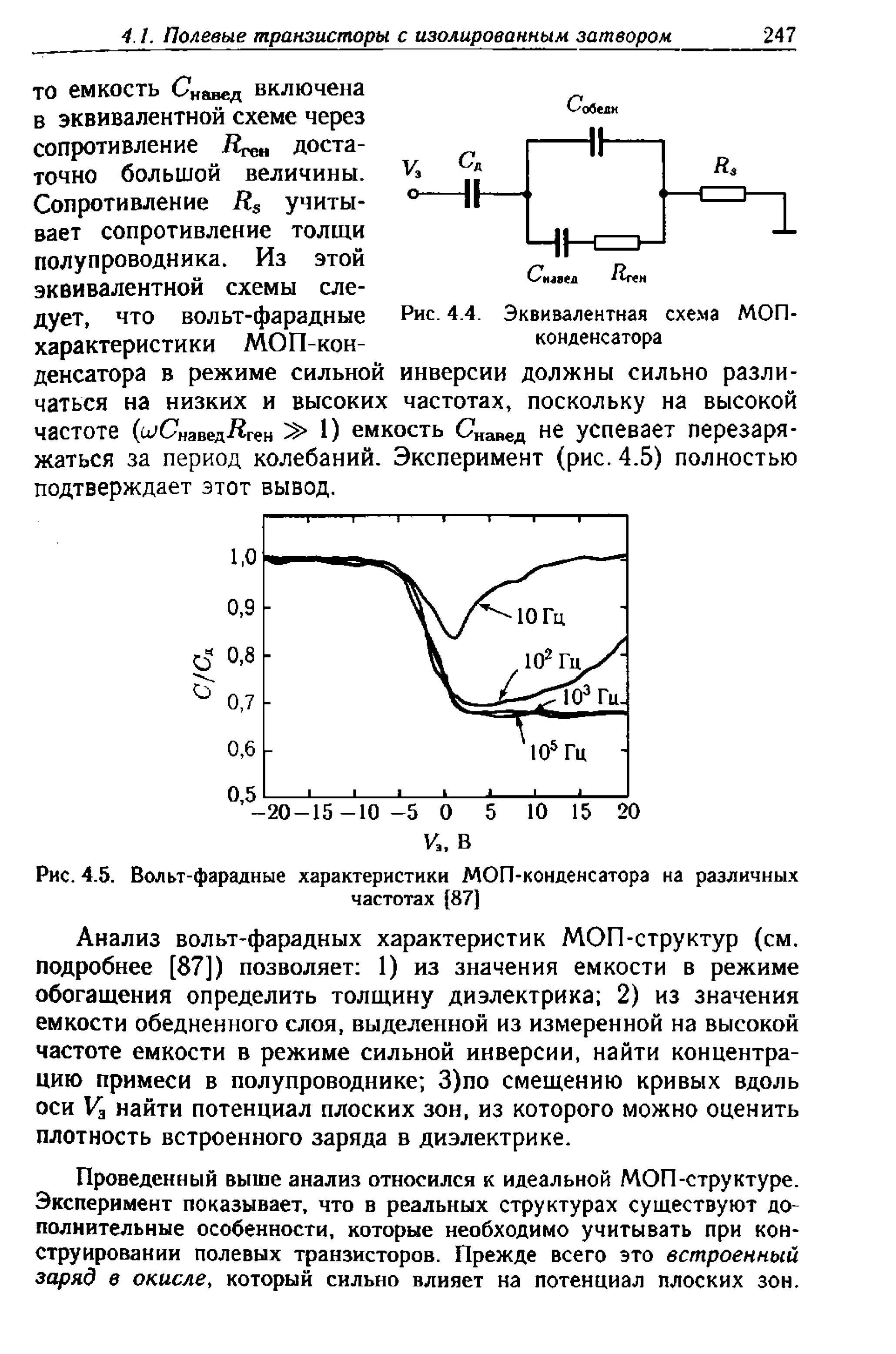
4.1. Полевые транзисторы с изолированным затвором
247
то емкость Снавед включена
в эквивалентной схеме через
сопротивление R^» доста-
точно большой величины.
Сопротивление R
s
учиты-
вает сопротивление толщи
полупроводника. Из этой
эквивалентной схемы сле-
дует, что вольт-фарадные
характеристики МОП-кон-
денсатора в режиме сильной инверсии должны сильно разли-
чаться на низких и высоких частотах, поскольку на высокой
частоте
(и>С„авед-йген
» 0 емкость С„
аВ
ед не успевает перезаря-
жаться за период колебаний. Эксперимент (рис. 4.5) полностью
подтверждает этот вывод.
1,0
0,9
tf 0.8
&
0,7
0,6
0,5
-20-15 -10 -5 0 5 10 15 20
К, В
Рис. 4.5. Вольт-фарадные характеристики МОП-конденсатора на различных
частотах [87]
Анализ вольт-фарадных характеристик МОП-структур (см.
подробнее [87]) позволяет: 1) из значения емкости в режиме
обогащения определить толщину диэлектрика; 2) из значения
емкости обедненного слоя, выделенной из измеренной на высокой
частоте емкости в режиме сильной инверсии, найти концентра-
цию примеси в полупроводнике; 3)по смещению кривых вдоль
оси V
a
найти потенциал плоских зон, из которого можно оценить
плотность встроенного заряда в диэлектрике.
Проведенный выше анализ относился к идеальной МОП-структуре.
Эксперимент показывает, что в реальных структурах существуют до-
полнительные особенности, которые необходимо учитывать при кон-
струировании полевых транзисторов. Прежде всего это встроенный
заряд в окисле, который сильно влияет на потенциал плоских зон.
Рис. 4.4. Эквивалентная схема МОП-
конденсатора

248
Гл. 4. Полевые транзисторы
На границе раздела Si-SiC^, полученной термическим окислением
кремния, всегда присутствуют четыре (!) различных по своей приро-
де источника заряда [14, 58]. Это — заряд быстрых поверхностных
состояний в полупроводнике, постоянный заряд в окисле, заряд на
ловушках в слое окисла и заряд подвижных ионов. Энергетическая
плотность быстрых поверхностных состояний, которые расположены
непосредственно на границе Si-SiO^, сильно зависит от режима по-
лучения окисла и ориентации поверхности полупроводника; ее удается
снизить до ~Ю
10
см~
2
эВ~
1
отжигом в атмосфере форминг-газа (смеси
10%H2+90%N2) при 450 °С. Поскольку заряд поверхностных состоя-
ний меняется при изменении поверхностного потенциала и экранирует
внешнее электрическое поле, эти состояния уменьшают величину ин-
дуцированного заряда в инверсионном слое и ухудшают характеристи-
ки МОП-транзисторов. Кроме того, поверхностные состояния являются
источником поверхностного шума в приборах с зарядовой связью.
Постоянный заряд в окисле (обычно положительный) имеет по-
верхностную плотность 10
10
—10
12
см"
2
и располагается в слое толщи-
ной ~30 А вблизи границы раздела Si-SiO
x
. Величина этого заряда
зависит от режима окисления, условий отжига и ориентации подложки
(наименьшую плотность постоянного заряда имеет кремний с ориента-
цией <100>).
Заряд на ловушках в слое окисла представляет собой объемный
заряд, захваченный на энергетические уровни дефектов в S1O2; его по-
верхностная плотность может меняться в пределах 10
9
-10
13
см"
2
. Этот
тип заряда ассоциируется с медленными поверхностными состояниями,
которые являются одной из главных причин возникновения фликкер-
шума. Заряд на ловушках в слое окисла «отжигается» в ходе низко-
температурной термообработки структуры, но может появляться при
облучении МОП-структуры (например, при имплантации ионов через
тонкий слой подзатворного диэлектрика с целью коррекции порогового
напряжения МОП-транзистора) или при лавинной инжекции заряда в
ЛИЗМОП-структурах (см. с. 286).
Наконец, заряд подвижных ионов связан с присутствием в окисле
ионов щелочных металлов (Na
+
, К
+
, U+) и ионов тяжелых металлов,
а также отрицательно заряженных ионов (ОН~), попадающих в окисел
из окружающей среды и материалов, используемых в технологическом
процессе. Поверхностная плотность этих зарядов обычно лежит в пре-
делах Ю
10
-1СР см"
2
,
Ионы щелочных металлов (прежде всего, ионы натрия) подвижны
в Si02 уже при 100 °С и под действием электрического поля могут
перемещаться в диэлектрике, вызывая медленный дрейф порогового
напряжения. Для связывания эти ионов сотрудники IBM в 1964 г.
предложили обрабатывать окисел в Р2О5; образующееся при последу-
ющем нагревании фосфорно-силикатное стекло является хорошим гет-
тером натрия и прочно связывает его ионы. Позже был предложен еще
один способ связывания ионов Na — окисление кремния в присутствии
хлорсодержащих газов (например, НС1); при этом попавший в окисел
хлор прочно связывает ионы натрия в форме NaCl,
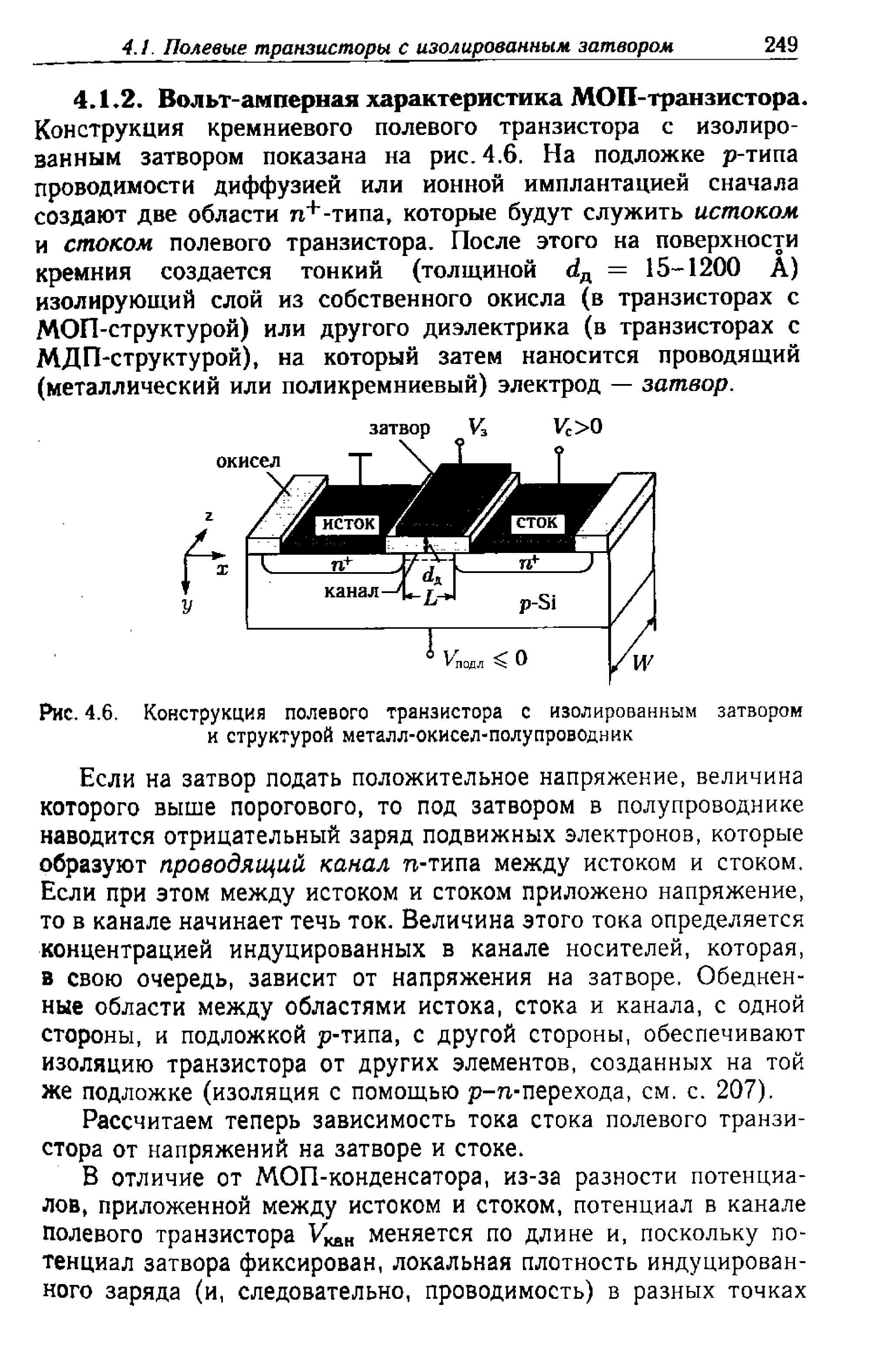
4.1. Полевые транзисторы с изолированным затвором
249
4.1.2. Вольт-амперная характеристика МОП-транзистора
Конструкция кремниевого полевого транзистора с изолиро-
ванным затвором показана на рис. 4.6. На подложке р-типа
проводимости диффузией или ионной имплантацией сначала
создают две области п
+
-типа, которые будут служить истоком
и стоком полевого транзистора. После этого на поверхности
кремния создается тонкий (толщиной <2
Д
= 15-1200 А)
изолирующий слой из собственного окисла (в транзисторах с
МОП-структурой) или другого диэлектрика (в транзисторах с
МДП-структурой), на который затем наносится проводящий
(металлический или пол
и
кремниевый) электрод — затвор.
затвор Vc>0
окисел
Рис. 4.6. Конструкция полевого транзистора с изолированным затвором
и структурой металл-окисел-полупроводник
Если на затвор подать положительное напряжение, величина
которого выше порогового, то под затвором в полупроводнике
наводится отрицательный заряд подвижных электронов, которые
образуют проводящий канал тг-типа между истоком и стоком.
Если при этом между истоком и стоком приложено напряжение,
то в канале начинает течь ток. Величина этого тока определяется
концентрацией индуцированных в канале носителей, которая,
в свою очередь, зависит от напряжения на затворе. Обеднен-
ные области между областями истока, стока и канала, с одной
стороны, и подложкой р-типа, с другой стороны, обеспечивают
изоляцию транзистора от других элементов, созданных на той
же подложке (изоляция с помощью р-п-перехода, см. с. 207).
Рассчитаем теперь зависимость тока стока полевого транзи-
стора от напряжений на затворе и стоке.
В отличие от МОП-конденсатора, из-за разности потенциа-
лов, приложенной между истоком и стоком, потенциал в канале
полевого транзистора Vkah меняется по длине и, поскольку по-
тенциал затвора фиксирован, локальная плотность индуцирован-
ного заряда (и, следовательно, проводимость) в разных точках

250 Гл. 4. Полевые транзисторы
канала оказывается различной. Если считать, что продольная
компонента напряженности электрического поля в канале £
х>
создаваемая разностью потенциалов между истоком и стоком,
много меньше поперечной компоненты напряженности поля £
у
,
создаваемой затвором, то искривлением линий электрического
поля под затвором можно пренебречь, и плотность наведенно
в данной точке заряда определяется разностью потенциалов меж-
ду этой точкой канала и затвором. Это приближение получило
название приближения плавного канала.
Будем считать, что напряжение на затворе
V
3
настолько ве-
лико, что во всех точках канала инверсия оказывается сильной.
Положим потенциал истока равным нулю (Укан(О) = 0), а по-
тенциал на стоке равным V^ = V
KaH
(L) > 0. Кроме этого, будем
считать, что подложка транзистора соединена с истоком (Vn
OAT
=
= 0). Учитывая, что появлению проводящего канала отвечает
условие
V
n
~ 2</>
0
б, из уравнений (4.6) и (4.7) находим локальную
плотность поверхностного заряда в полупроводнике:
Qnn(x) * -С
Д
[У
3
- v
m
- 2ф
об
- Кан(я)]. (4.10)
Как мы отмечали выше, этот заряд состоит из заряда обед-
ненного слоя и заряда подвижных носителей: Q
nn
= Фобедн +
+ qn
S8
. Поверхностная плотность заряда обедненного слоя легко
находится из решения уравнения Пуассона (4.2) и равна
W*) = = .
(4.11)
Это позволяет нам найти изменение поверхностной плотности
подвижного заряда qn
S3
вдоль канала.
Расчет вольт-амперной характеристики заметно упрощает-
ся, если пренебречь изменением величины Победи вдоль канала
(см. уравнение (4.11)) и считать эту величину постоянной. Это
приближение получило название модели управления зарядом.
В этом приближении локальная плотность подвижного заряда
связана с напряжением в данной точке канала соотношением
qn
3S
(x) и -С
Д
[К - F
nop
- ^„(х)], (4.12)
где F
n0
p - У
пз
+ 2<£об - Фобедн/Од есть некоторое эффективное
пороговое напряжение, зависящее от среднего значения ф
0
б
едн
') Из-за зависимости qn
ae
от
Qo6*
a
»
МОП-транзистор оказывается не трех-
электродным, а
четырехзлектродным
прибором, которым можно управлять

4.1- Полевые транзисторы с изолированным затвором
251
-50
<
а
2 -20
-10
-10
Рис. 4.7. Выходные характеристики промышленного МОП-транзистора 2SJ343
фирмы Toshiba с каналом р-типа
Если считать, что подвижность носителей /i
n
не зависит от
напряженности электрического поля, то ток в канале шириной
W можно записать следующим образом*):
L = \qn
ss
\ii
n
W
dV.
как
= 1ЛпЖС
д
[У
3
- Кор - КанМ]
dV,
кан
DX
(4.13)
После разделения переменных это уравнение можно переписать
так:
1
dx = -rlflnWC^V, - V
nop
-
Укан)]
dV
K&H
.
(4.14)
Интегрируя это уравнение по всей длине канала (от х = 0 до L),
находим:
0
W Г V
2
1
= [V
3
- V
aop
)V
c
-
(4.15)
Это решение остается справедливым, пока во всех точках канала
\qn
8S
\ > 0. При V
c
> V
c
,
Hac
= V
nopt
когда, в соответствии
с формулой (4.12), в самой «узкой» части канала около стока
к со стороны подложки. Так, подавая отрицательное смещение на подложку,
мы увеличиваем заряд Победи] и, следовательно, уменьшаем |qn
s
&\ и ток
в транзисторе.
]
) В этом уравнении мы считаем ток чисто дрейфовым и пренебрегаем диф-
фузионной составляющей тока, которая может возникать из-за неоднородного
распределения в канале поверхностной концентрации подвижных носителей.
Оценки показывают, что это приближение является хорошим, пока канал ни
в одной точке не перекрывается.
